Samsung предложит клиентам передовую упаковку чипов, а также будет подселять к сторонним CPU свою DRAM
Внимание производителей микросхем и их клиентов всё сильнее привлекают передовые технологии упаковки, которые повышают производительность за счёт эффективной компоновки микросхем. Samsung Electronics, второй в мире контрактный производитель чипов, начала предоставлять услуги по передовой упаковке и тестированию чипов для клиентов своего контрактного производства, стремясь конкурировать с мировым лидером TSMC на фоне стремительного роста сектора ИИ.
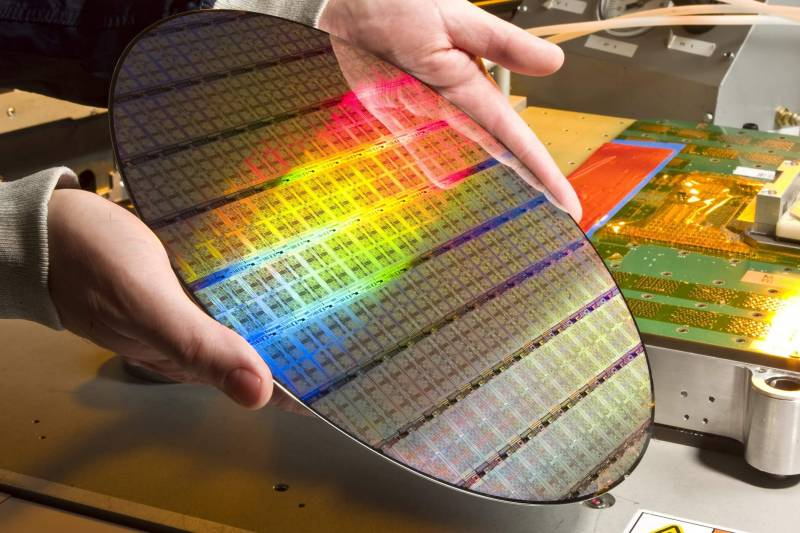
Источник изображения: Techpowerup
Samsung предлагает дополнять решения клиентов своими флагманскими решениями, например, добавляя к центральными процессорам на одну подложку свои микросхемы оперативной памяти DRAM. Так компания хочет привлечь крупные технологические компании, разрабатывающие свои собственные микросхемы для ИИ. «Samsung является комплексным производителем полупроводников, который может работать во всех сферах деятельности, — заявил представитель компании. — Мы обеспечиваем наилучшую производительность на всех этапах процесса производства чипов, чтобы помочь клиентам внедрять инновации».
Сегмент передовой упаковки чипов быстро растёт. Согласно прогнозам, к 2027 году этот сегмент мирового рынка вырастет почти втрое до $7,9 млрд с $2,7 млрд в 2021 году. Samsung уже приняла различные меры для расширения своего присутствия на рынке. Компания разработала память с высокой пропускной способностью (HBM), которая позволяет обрабатывать большой объём данных за счёт объединения нескольких микросхем DRAM, а также продвигает технологию гетерогенной интеграции, которая соединяет HBM и CPU.
В конце прошлого года компания создала отдельную команду для передового упаковочного бизнеса под непосредственным контролем Кён Ке Хёна (Kyung Kye Hyun), президента и главного исполнительного директора подразделения решений для устройств Samsung. «Мы помогаем клиентам справиться с быстрыми изменениями рыночного спроса» , — заявил представитель Samsung.
Samsung готова предоставить клиентам передовые технологии для упаковки нескольких микросхем в один корпус, такие как 2,5D и 3D. В 2,5D-структуре несколько чипов размещаются бок о бок на кремниевой подложке для достижения чрезвычайно высокой плотности межсоединений. В 3D-структуре микросхемы упаковываются путём укладки одна на другую для обеспечения кратчайшего межсоединения и наименьшей занимаемой площади.
Samsung стремится привлечь крупные технологические компании, такие как Google, Microsoft, Tencent, которые продвигают технологии ИИ и высокопроизводительных вычислений, для комплексного обслуживания «под ключ». Этим глобальным технологическим гигантам требуются высокопроизводительные чипы с максимальной плотностью размещения. Услуги Samsung по упаковке позволяют этим компаниям сократить время на закупку полупроводников и сократить расходы на управление цепочками поставок.
Samsung надеется увеличить свою долю рынка за счёт крупнейшего в мире производителя полупроводниковых изделий TSMC, на долю которого сейчас приходится более 50 % мировой отрасли. Это весьма амбициозная задача, так как TSMC только на Тайване располагает пятью заводами по упаковке чипов, а в июне прошлого года открыла центр исследований и разработок для технологий 3D-упаковки в Японии.
