Samsung в следующем году представит передовую технологию 3D-упаковки чипов SAINT
Samsung планирует в следующем году представить передовую пространственную технологию упаковки чипов, которая поможет компании составить полноценную конкуренцию мировому лидеру в сфере контрактного полупроводникового производства в лице TSMC, пишет Korea Electronic Daily.
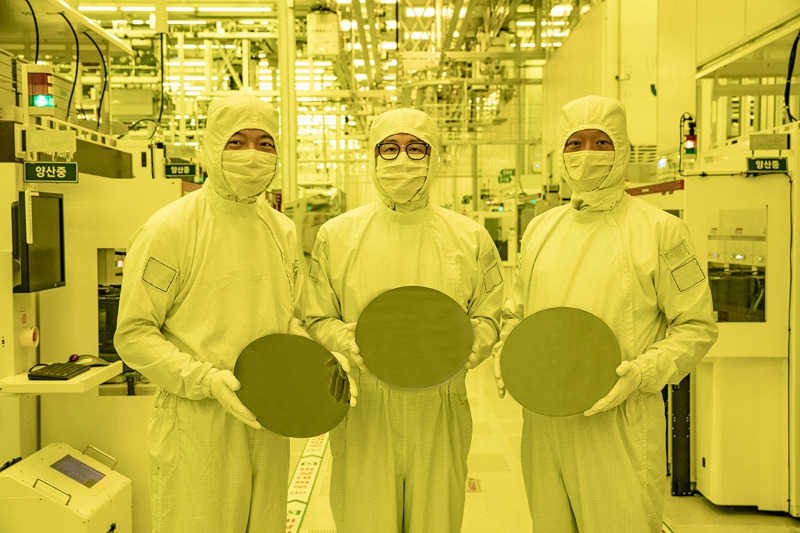
Источник изображения: samsung.com
Новая технология 3D-упаковки получила название SAINT (Samsung Advanced Interconnection Technology) — она позволяет интегрировать процессоры с памятью, получая на выходе высокопроизводительные чипы, в том числе для систем искусственного интеллекта, значительно более компактные в сравнении с существующими. Под брендом SAINT корейский производитель представит три типа решений: SAINT S с вертикальным расположением памяти SRAM и центрального процессора; SAINT D с вертикальной компоновкой памяти DRAM и центрального и/или графического процессоров; а также SAINT L для специализированных компонентов. Используемая Samsung технология упаковки 2,5D в большинстве случаев предполагает горизонтальное размещение составляющих. Некоторые из решений, в том числе SAINT S, уже прошли первичные испытания — за ними последует тестирование совместно с клиентами и коммерческий запуск технологий.
Упаковка является одним из последних этапов производства полупроводниковой продукции. На этом этапе микросхема помещается в защитный корпус, который предотвращает её коррозию и обеспечивает интерфейс для соединение с другими микросхемами в компьютере. Ведущие производители чипов в лице TSMC, Samsung и Intel жёстко конкурируют за передовые технологии упаковки, позволяющие объединять разные компоненты и размещать их вертикально. Передовые технологии помогают повысить производительность электроники без смены техпроцесса — «уменьшения нанометров», но они отличаются высокой технологической сложностью и требуют больше времени. Мировой рынок передовых технологий упаковки микросхем с 2022 до 2027 года вырастет с $44,3 до $66 млрд — из них на 3D-упаковку придётся около четверти или $15 млрд.
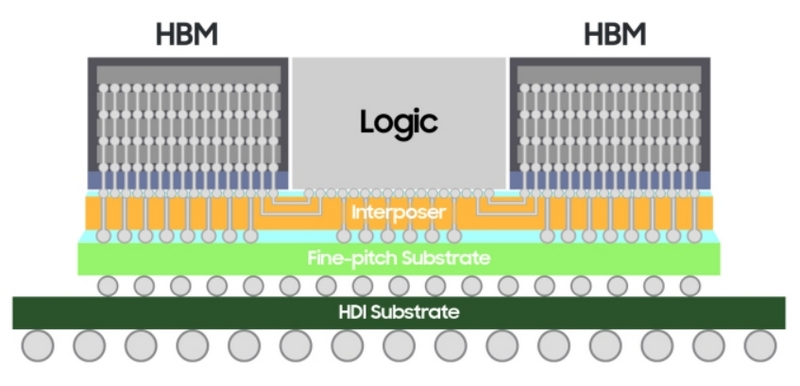
2,5D-упаковка Samsung H-Cube
Samsung, второй по величине контрактный производитель полупроводников в мире, в 2021 году представила собственную технологию 2,5D-упаковки H-Cube — она позволяет размещать логические компоненты или HBM-память вертикально на кремниевых переходниках. В апреле компания заявила о готовности предлагать услуги создания чипов «под ключ», включая весь процесс от производства чипов до их упаковки и тестирования. Технология SAINT поможет Samsung повысить производительность чипов и адаптировать их под системы искусственного интеллекта как для дата-центров, так и для мобильных устройств с возможностью локальной обработки алгоритмов.
