Компания Samsung Electronics создала рабочую группу по разработке новых технологий упаковки полупроводников, которая займётся, в том числе, расширением сотрудничества с крупными компаниями, занятыми в этой сфере. Эта группа, сформированная бизнес-подразделением Device Solutions (DS) в середине июня, находится в прямом подчинении возглавляющему DS гендиректору Samsung Кюн Ки Хёну (Kyung Kye-hyun).
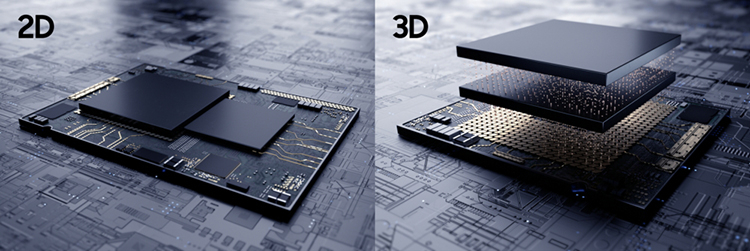
Источник изображения: Samsung
В новую группу вошли инженеры команды Test & System Package (TSP) подразделения DS, специалисты Центра исследований и разработок полупроводников, а также сотрудники подразделений Samsung по производству памяти и других чипов. Перед группой поставлена задача предложить передовые решения по упаковке полупроводников.
Этот шаг показывает, какое значение Кюн Ки Хён придаёт передовым технологиям упаковки полупроводников. В настоящее время, когда миниатюризация микросхем приближается к своим пределам, набирают популярность технологии 3D-упаковки, позволяющие объединить микросхемы, изготовленные с использованием разных техпроцессов, в единый чип.
Глобальные полупроводниковые гиганты, такие как Intel и TSMC, активно инвестируют в разработку технологий усовершенствованной упаковки чипов. По данным исследовательской фирмы Yole Development, в 2022 году на долю Intel и TSMC приходится соответственно 32 % и 27 % глобальных инвестиций в разработку передовых технологий упаковки полупроводников. По уровню инвестиций в этой сфере Samsung Electronics занимает четвёртое место после ASE, тайваньской компании, занимающейся упаковкой и тестированием интегральных схем.
Intel использует для производства чипов технологию пространственной упаковки Foveros. В частности, с её помощью был изготовлен процессор Lakefield, вышедший в 2020 году, который нашёл применение в ноутбуках Samsung Electronics. Также 3D-упаковку чипов уже использует TSMC при изготовлении процессоров для компании AMD.
Samsung также активно работает над этим направлением. В 2020 году южнокорейская компания представила технологию X-Cube для 3D-упаковки чипов памяти с расположением ОЗУ SRAM на кристалле логики или центральном процессоре. А президент и глава подразделения по производству чипов Чой Си Ён (Choi Si-young) заявил на ежегодной конференции Hot Chips 2021, что компания разрабатывает «3,5D-упаковку» чипов.
Источник:


 MWC 2018
MWC 2018 2018
2018 Computex
Computex
 IFA 2018
IFA 2018

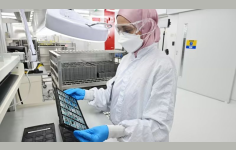





 В России представили первый в мире полностью беспилотный робот-трактор
35
В России представили первый в мире полностью беспилотный робот-трактор
35
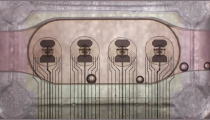 Запущен первый в мире биопроцессор из 16 органоидов мозга с удалённым доступом — он обладает высочайшей энергоэффективностью
32
Запущен первый в мире биопроцессор из 16 органоидов мозга с удалённым доступом — он обладает высочайшей энергоэффективностью
32
 Разработан материал, который пропускает больше света, чем стекло — а ещё он охлаждает помещения и самоочищается
25
Разработан материал, который пропускает больше света, чем стекло — а ещё он охлаждает помещения и самоочищается
25
 YouTube стал перематывать ролики в конец, если замечает блокировщик рекламы
24
YouTube стал перематывать ролики в конец, если замечает блокировщик рекламы
24
 Подписаться
Подписаться