Перевод: Дмитрий Чеканов, Сергей Мильчаков
Часто случается, что важным вещам не уделяется должное внимание. Взять, к примеру, статьи о процессорах. Там вы можете прочитать практически все о процессорах - узнаете о кристалле, об архитектуре процессора, познакомитесь с кэшем, с интерфейсом шины, с тактовой частотой: Список можно продолжать долго. Когда же дело касается факторов, влияющих на производительность и надежность процессоров, разговор идет в основном о технологическом процессе. Но и в этом случае мы читаем лишь о том, какого размера будет кристалл, каким ожидается выход годных кристаллов и каким будет размер элемента. Здесь мы упускаем из виду один из самых важных моментов, ключ к стабильности и производительности чипа, фактор, влияющий на возможность разгона чипа.
Процессор можно условно разделить на две основные части: кристалл (собственно, сам процессор), и упаковку, которая соединяет это ядро процессора со внешним миром. Именно от упаковки процессора зависит насколько высокой будет тактовая частота процессора, равно как и частота FSB. Вы спросите: как с помощью упаковки можно управлять тактовой частотой? Прежде чем ответить на этот вопрос, давайте пополним наши знания об упаковке процессора.
Анатомия упаковки
Рассмотрим современный процессор - например, AMD Duron, работающий на тактовой частоте 1ГГц.
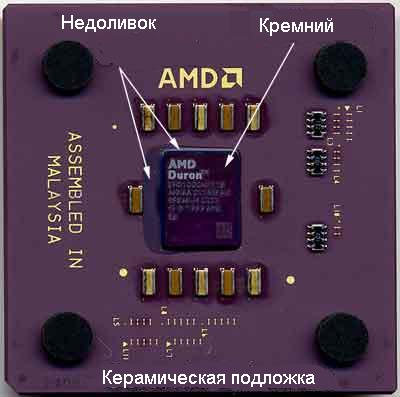
В центре чипа находится то, что обычно называется "ядром". Это тот кусок кремния, в котором и происходят все вычисления, запросы на загрузку и хранение, ветвления.
В нашем случае, кремний связан с остальной частью чипа (обычно обозначаемой термином "упаковка") по технологии flip-chip - "перевернутое ядро". Технология получила такое название потому, что видимая часть ядра на самом деле является его дном, ядро процессора перевернуто вверх тормашками, чтобы обеспечить прямой контакт с радиатором кулера для лучшей теплоотдачи - важной детали с учетом того количество тепла, которое выделяет современный процессор.
С невидимой стороны находится сам "интерфейс" - соединение кристалла и упаковки. Представьте, на крошечной пластине кремния нашего Duron находится 25,18 миллионов транзисторов, и часть из них надо соединить с упаковкой, где находятся ножки процессора - для связи с внешним миром. Соединение ядра процессора с его упаковкой в нашем случае выполнено с помощью столбиковых выводов ("Solder Bumps"). Часто их просто называют выводами (bumps). В нашем конкретном случае таких выводов на нижней части кремния - около трех тысяч. Для сравнения в Pentium 4 таких выводов около пяти тысяч, а в Intel Itanium - около семи с половиной тысяч выводов. Конечно же, размер выводов крайне мал, а их расположение точно вымерено. С увеличением сложности самого процессора, сложнее становится и размещать эти выводы. Запомните этот факт, впоследствии мы еще вернемся к нему.

Так как вся работа процессора выполняется на кристалле, здесь рассеивается довольно большое количество тепла. Если во время работы процессора прикоснуться к его упаковке, она не покажется вам слишком горячей, но если бы вы задели ядро процессора - вы бы почувствовали разницу. Такая разница в температуре становится причиной некоторых проблем. Как вы знаете, в зависимости от температуры, тела имеют обыкновение сжиматься и расширяться. Поэтому если ядро работает при температуре 50 градусов, а упаковка нагрета лишь до 27, скорее всего возникнут проблемы - ядро будет расширяться с одной скоростью, а упаковка - с другой. Если не принять это во внимание, что-нибудь может просто-напросто треснуть.
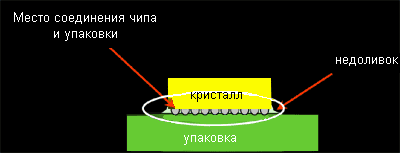
Настал черед поговорить о голубом или красном веществе, окружающем ядро. Можно заметить, что оно закрывает ядро со всех сторон, и даже "размазано" несколько дальше. Это вещество называется недоливком (Underfill). Вещество это предназначено для уменьшения давления, и находится оно между ядром и упаковкой, а также вокруг основания соединения ядра с упаковкой - для компенсации разницы температур. Так как это недоливок играет определенную роль при соединении ядра с упаковкой, проблемы с этим веществом могут стать причиной дефекта процессора. Это как раз тот случай, когда на качество ядра жаловаться не приходится, но качество самого процессора оказывается удручающим.
И, наконец, мы добрались до материала, из которого выполнена сама упаковка или подложка. В нашем случае, упаковка выполнена из керамики, но в процессорах Intel начиная с P54C (последние версии Pentium Classic) упаковка сделана из органических веществ - от этого она становятся легче, кроме того, у них появились и другие преимущества. Но об этом позднее.
Связь с внешним миром
Итак, мы выделили основной источник проблем в современных упаковках - ограничение на количество столбиковых выводов, используемых для соединения ядра и упаковки. Пока эта проблема стоит не так остро, но через несколько лет она может доставить достаточно хлопот. Ниже мы рассмотрим способы решения этой проблемы.
Теперь мы знаем, что данные попадают с ядра процессора на подложку через столбиковые выводы. Что с ними происходит дальше? Дальнейший путь лежит через сотни контактов снизу процессора, но прежде чем попасть на эти выводы, сигнал должен пройти через саму упаковку.

Для примера возьмем процессор Pentium III в корпусе FC-PGA (Flip Chip Pin Grid Array). У этого процессора можно заметить линии на подложке. Так как процессоры усложняются, количество кремния уменьшается (совершенствуется технологический процесс), возрастает сложность и стоимость компоновки проводников на подложке, от ядра к ножкам процессора.
Следующее ограничение - в сущности самой упаковки: ядро находится сверху, контакты - снизу, это значит, что прежде чем сигнал попадет из ядра на контакты, он должен как-то пройти саму упаковку. Если бы мы могли видеть сквозь подложку, то в увеличенном виде то пространство, которое должен преодолеть сигнал, выглядело бы как слоистая диаграмма (на рисунке чуть ниже).
На вершине подложки находятся крепежные площадки, которые соединяют столбиковые выводы с кристаллом. Место в нижней части подложки предназначено для ножек, центральная же часть этого бутерброда представляет собой то, что мы называем сквозными микро-перемычками (micro-vias) или просто перемычками. Эти перемычки буквально соединяют верхнюю и нижнюю части упаковки. В современных процессорах насчитывается до 10 000 таких микро-перемычек, а пройдет ещё немного времени (несколько лет), и этих перемычек станет в 3-5 раз больше.
К чему весь этот разговор?
Из всего сказанного следует логичный вывод - для будущих процессоров нужны новые технологии упаковок. Процессоры будущего станут ещё сложнее, потребуются более эффективные методы соединения ядра с подложкой, размеры кристаллов будут уменьшаться, при этом компоновка проводников лишь усложнится. А тем временем будет увеличиваться тактовая частота процессоров, а значит, будут изменяться и требования к точности самой упаковки.
С увеличением тактовой частоты, от производителей чипов можно ожидать развития упаковочной технологии. За примером далеко ходить не обязательно: впервые процессор AMD - Athlon XP - использует подложку из органического вещества. Довольно долгое время AMD изготавливала подложки из керамики, тогда как её конкуренты в лице Intel уже давно использовали для этих целей органические вещества. Переход с керамики был обусловлен необходимостью увеличения таковой частоты процессоров линейки Athlon.
Кроме того, растет и частота системной шины. Например, частота шины ядра Intel Northwood (Pentium 4 по технологии 0,13 мкм) составит 533 МГц, частота шины Intel Prescott - 800 МГц, а объявленная частота шины Intel Tejas - 1,2 ГГц.
AMD тоже не дремлет. Говорят, частота системной шины их процессоров Hammer составит 800 МГц. Поэтому нисколько не удивительно было бы то, что одной из причин введения упаковки из органических веществ являлось бы стремление AMD улучшить работоспособность и стабильность процессоров Hammer.
Но вспомните старую молву о неустойчивой работе Palomino с частотой системной шины 133МГц. Скорее всего, именно это и стало причиной перехода с керамических упаковок на органику.
Экономика должна быть экономной
Все вы наверняка не раз слышали о том, что "компьютеры работают лишь с ноликами и единичками". На самом деле, процессор выполняет массу работы - он анализирует напряжение на различных комбинациях транзисторов, и определяет нолик или единичку в зависимости от значения этого напряжения (высокое оно или низкое, например, 5В или 0В).
Теперь давайте посмотрим, что случилось с напряжением за последнее время. Несколько лет назад, напряжение ядра процессоров Pentium 60/66 МГц составляло 5 В, в современных процессорах оно опустилось ниже 1,75 В. Из-за такого постоянного снижения напряжения разница между положениями "есть сигнал" и "нет сигнала" становиться очень незначительной, что и позволяет различного рода помехам из ноликов делать правдоподобные единички. Все это приводит к нестабильности и к сбоям в работе.
Выход из этой ситуации достаточно прост: добавить конденсаторы, чтобы отфильтровать шумы. Единственная проблема с таким "простым" решением в том, что располагаться эти конденсаторы должны достаточно близко к ядру, и зависит это расстояние, как вы уже наверно догадались, от упаковки. Именно поэтому мы наблюдаем конденсаторы - они находятся с нижней стороны процессора Pentium 4 и Athlon XP, прямо под ядром.
Безударно наращиваемый слой (Bumpless Build-Up Layer): будущее упаковочной технологии
Хотя AMD не раз показывала свое преимущество в производительности над Intel, превзойти Intel по части производственной базы ей не удалось. В частности, у Intel существует специальное подразделение, занимающееся исключительно упаковкой для процессоров будущего. Intel не раз заявляла о миллиарде транзисторов в чипах с частотой за 10 ГГц, поэтому неудивительно, что около тысячи человек занимается лишь технологиями упаковки. Подразделение Intel по разработке сборочных технологий (Assembly Technology Development) насчитывает 900 человек, большинство из них трудится в Аризоне. Именно здесь рождаются новости упаковочных технологий.
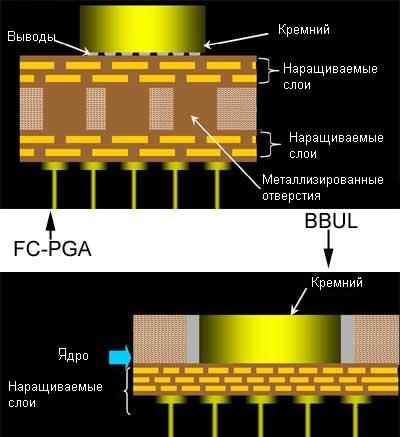
Хотя новая технология безударно наращиваемого слоя (Bumpless Build-Up Layer, BBUL) от Intel вряд ли будет внедрена в производство в ближайшие 5-6 лет, несомненно, будущее именно за ней. Красота этого решения в том, что кристалл будет интегрирован в подложку. При производстве процессоров по технологии BBUL сначала будет создан первый слой упаковки, и одновременно в эту упаковку будет запечатана уже проверенная кремниевая пластина. Вспомните о проблемах с плотностью расположения столбиковых выводов. В новой технологии подобных проблем не возникнет - этих выводов просто не станет. Кремниевая пластина будет заключена непосредственно внутри корпуса. Ещё одно достоинство такого решения: так как ядро больше не выступает за положку, уменьшается вероятность порчи ядра вследствие неаккуратной установки кулера. Впрочем, Intel уже заявляла, что они вероятно продолжат использовать распределители тепла, так что в любом случае вы не повредите кристалл.
Кроме того, в результате такого решения становится возможным размещать конденсаторы на дне процессора ближе к ядру, отчего повышается эффективность доставки энергии (снижается потребляемая мощность). Становиться тоньше и сама упаковка, причем, судя по изображению, намного тоньше. Отметим, что прототип BBUL чипа использовал ядро, сравнимое по размеру с Intel Northwood 0,13 мкм и выводов он не имел. Вероятнее всего, у коммерческих образцов ножки появятся. За фотографии поблагодарим Intel Corporation.

Слева: Прототип BBUL чипа, справа: кредитная карточка
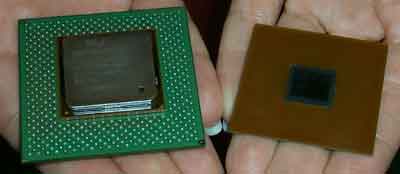
Слева: Чип Pentium 4, справа: прототип BBUL чипа
Кроме того, с подобными упаковками нетрудно создавать многоядерные процессоры. Одна из главных проблем при создании такого рода процессоров заключается в том, что тестировать такой процессор необходимо уже в собранном виде. И если при тестировании выявлялся брак одного из ядер, будет отбраковываться весь процессор (похоже, что AMD со своим SledgeHammer скоро столкнется с этой проблемой). Новая же технология позволяет встраивать ядра на отдельные подложки, и затем соединять их высокоскоростной внутренней шиной. При этом достигается и высокая производительность, равно как появляется возможность индивидуальной отбраковки ядра перед сборкой ядер в один процессор.
Итог
Определенно, новая технология Intel BBUL - это большой шаг вперед в упаковочной технологии. Она еще поработает на благо всех производителей, так как она позволяет упаковывать чипсеты, встраивать высокопроизводительные графические ядра в северные мосты, и даже обеспечивать производительный L3 кэш, встроенный в упаковку многоядерных процессоров.


 MWC 2018
MWC 2018 2018
2018 Computex
Computex
 IFA 2018
IFA 2018






