Компания TSMC сообщила об открытии Advanced Backend Fab 6 — своей первой комплексной фабрики, на которой будет применяться весь спектр автоматизированных процессов для производства передовых технологий упаковки и тестирования чипов с использованием технологий 3D-корпусировки 3DFabric.

Источник изображений: TSMC
TSMC 3DFabric представляет собой технологию 3D-штабелирования и упаковки микросхем, состоящую как из frontend-составляющей, так и из backend-технологий, включая технологии упаковки SoIC, CoWoS и InFO, обеспечивающих лучшие производительность, мощность, формфактор и функциональность.
На новом заводе TSMC будет применяться технология трёхмерной упаковки полупроводниковых элементов (System on Integrated Chip, SoIC), подразумевающая вертикальное стекирование компонентов чипа на одной подложке в новую интегрированную систему SoC согласно процессу стекирования SoIC-CoW (на изображении выше), а также использование технологии SoIC-WOW, подразумевающей применение сквозных соединений микросхем Through Silicon Via (TSV), которые позволяют сократить толщину микросхем.
Метод упаковки TSMC SoIC используется той же компанией AMD для своих процессоров с кеш-памятью 3D V-Cache. А именно кристалл памяти SRAM устанавливается поверх кэша L3 на кристалле Ryzen CCD, за счёт чего происходит увеличение общего объёма кеш-памяти L3. TSV проходят сквозь кристалл CCD до слоя SRAM. Контактные шарики Micro bumps для связи кристаллов уже не используются.
Строительство завода Advanced Backend Fab 6 началось в 2020 году в ответ на растущий спрос на чипы для высокопроизводительных вычислений, ИИ, мобильных и других приложений. Новая фабрика TSMC расположена в научном парке Чжунань и имеет базовую площадь в 14,3 га, что делает её на сегодняшний день крупнейшим backend-заводом TSMC для сборки микросхем. По прогнозам компании, завод сможет обрабатывать свыше миллиона 300-мм кремниевых пластин с использованием технологии трёхмерной корпусировки 3DFabric и сможет проводить более 10 млн часов тестирований в год.
«Стекирование микросхем является ключевой технологией для повышения производительности и экономичности чипов. Для удовлетворения повышенного спроса рынка в создании трёхмерных интегральных схем (3D IC), то есть чипов с объёмной компоновкой, компания TSMC завершила развёртывание передовых производственных мощностей для использования технологии упаковки и стекирования кремния и развивает технологические преимущества с помощью платформы 3DFabric», — прокомментировал Джун Хе, вице-президент компании по производству, использования передовых технологий упаковки чипов и обслуживанию клиентов.
На новой фабрике компания TSMC будет применять технологии ИИ для оптимизации эффективности производства. Общая протяжённость автоматизированной системы транспортировки и загрузки материалов составляет более 32 километров. Использующиеся на фабрике ИИ-алгоритмы позволят одновременно осуществлять точное управление процессами и обнаруживать какие-либо отклонения в работе линии в реальном времени.
Источник:


 MWC 2018
MWC 2018 2018
2018 Computex
Computex
 IFA 2018
IFA 2018

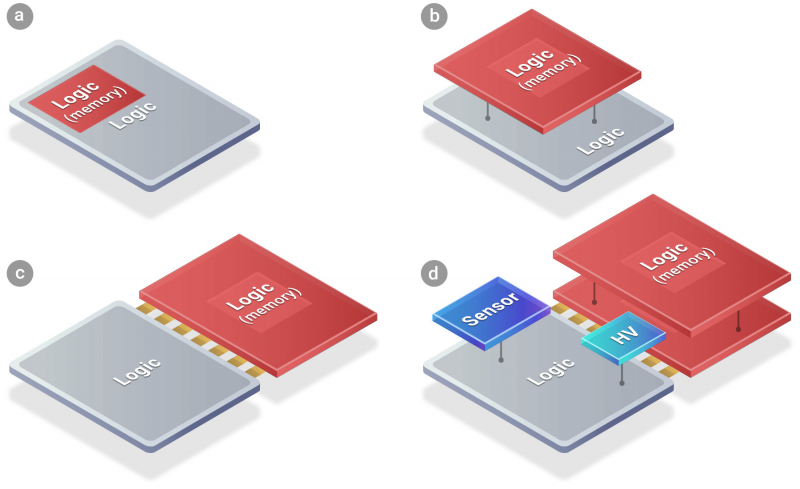
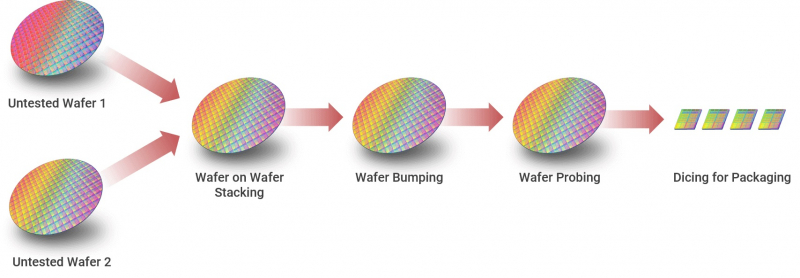
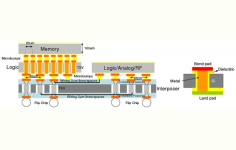
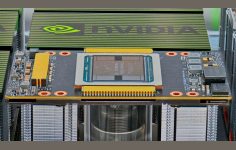
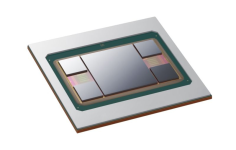

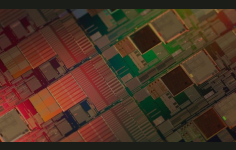

 Обзор Ryzen 5 8600G: новый король бюджетных сборок (нет)
59
Обзор Ryzen 5 8600G: новый король бюджетных сборок (нет)
59
 OpenAI представила ИИ-модель GPT-4o — она гораздо умнее старых версий и будет доступна бесплатно
38
OpenAI представила ИИ-модель GPT-4o — она гораздо умнее старых версий и будет доступна бесплатно
38
 Китай испытал рельсотрон для запуска снарядов в стратосферу, но что-то пошло не так
35
Китай испытал рельсотрон для запуска снарядов в стратосферу, но что-то пошло не так
35
 Обзор ASUS Zenbook 14 OLED (UX3405): ноутбук «всего» с одним дисплеем — зато каким!
24
Обзор ASUS Zenbook 14 OLED (UX3405): ноутбук «всего» с одним дисплеем — зато каким!
24
 Подписаться
Подписаться